Что такое BGA в PCB
В современном производстве электроники технология упаковки компонентов играет решающую роль. С развитием миниатюризации и повышением производительности электронных устройств технологии упаковки постоянно совершенствуются, чтобы удовлетворять требования к высокой плотности размещения, улучшенной производительности и компактным размерам. Шариковая решетка (Ball Grid Array, BGA) – это передовая технология поверхностного монтажа, которая благодаря своим уникальным преимуществам стала важной составляющей современной электронной промышленности.
BGA на печатных платах (PCB)
BGA (Ball Grid Array) – это упаковка для интегральных схем, используемая при поверхностном монтаже.(Вы можете нажать на ссылку с красным текстом, чтобы узнать больше о BGA) BGA использует массив шаровых контактов на нижней стороне микросхемы и обеспечивает более высокую плотность размещения компонентов, лучшие электрические характеристики и улучшенное теплоотведение по сравнению с традиционными поколенными упаковками с выводами. Внедрение технологии BGA значительно способствовало миниатюризации и повышению производительности электронных устройств.
Типы BGA упаковки
Упаковка в шариковую решетку по методу литья (MAPBGA)
Упаковка в шариковую решетку по методу литья (Molded Array Process BGA, MAPBGA) представляет собой тип упаковки, в котором микросхема и подложка формуются вместе. Этот способ упаковки обеспечивает более плотное соединение между микросхемой и подложкой, эффективно повышая надежность и механическую прочность упаковки.
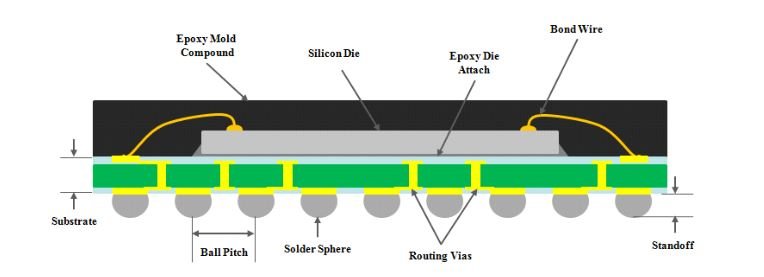
Пластиковая шариковая решетка (PBGA)
Пластиковая шариковая решетка (Plastic BGA, PBGA) использует пластик в качестве упаковочного материала, отличаясь низкой стоимостью и легким весом. PBGA широко применяется в различных потребительских электронных устройствах, таких как смартфоны и планшетные компьютеры.
Керамическая шариковая решетка (CBGA)
Керамическая шариковая решетка (Ceramic BGA, CBGA) использует керамические материалы в качестве основы упаковки, обладая отличными тепловыми характеристиками и механической прочностью. CBGA обычно используется в промышленности и военной технике, где требуются высокие показатели производительности и надежности.
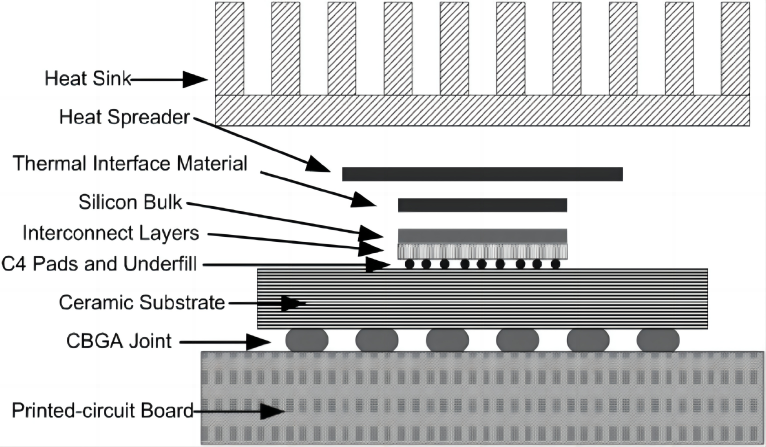
Теплоусиленная пластиковая шариковая решетка (TEPBGA)
Теплоусиленная пластиковая шариковая решетка (Thermal Enhanced Plastic BGA, TEPBGA) включает теплопроводящие материалы в пластиковый упаковочный материал для улучшения теплоотвода. TEPBGA подходит для электронных устройств с высокой плотностью мощности, таких как высокопроизводительные компьютеры и коммуникационное оборудование.
Ленточная шариковая решетка (TBGA)
Ленточная шариковая решетка (Tape BGA, TBGA) использует лентовый материал в качестве подложки, на которой размещены шарики пайки. Этот способ упаковки отличается хорошей гибкостью и адаптивностью, часто применяется для упаковки гибких печатных плат.
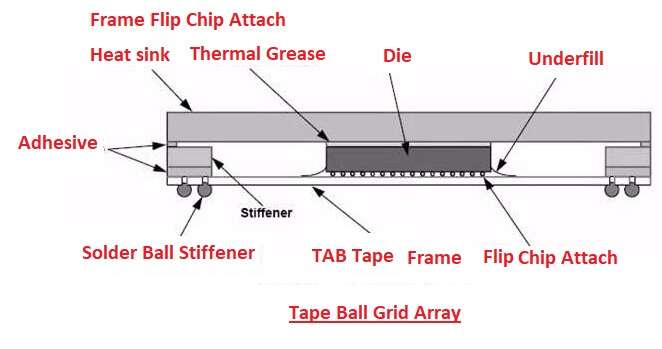
Шариковая решетка с малым шагом (FBGA)
Шариковая решетка с малым шагом (Fine-pitch BGA, FBGA) относится к типу упаковки BGA с расстоянием между шариками менее 1 мм. FBGA может еще больше повысить плотность упаковки и подходит для сверхвысокоплотного проектирования электронных устройств.

Шариковая решетка с микросхемой перевернутого типа (FCBGA)
Шариковая решетка с микросхемой перевернутого типа (Flip Chip BGA, FCBGA) – это тип упаковки, в котором микросхема напрямую переворачивается на подложку. Этот способ упаковки может значительно сократить путь соединения между микросхемой и подложкой, что улучшает электрические и тепловые характеристики.
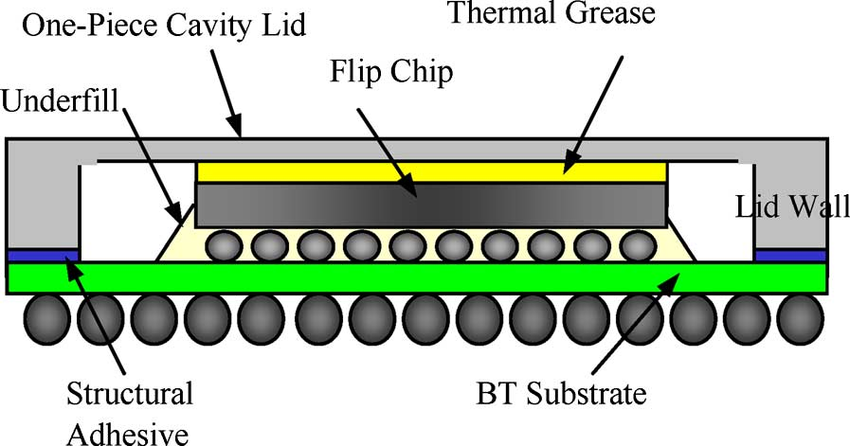
Преимущества и недостатки упаковки BGA
Преимущества
Эффективное использование пространства на PCB
BGA упаковка значительно повышает плотность размещения компонентов за счет расположения шариковых контактов на нижней стороне микросхемы. По сравнению с традиционной упаковкой с выводами, BGA позволяет разместить больше функций на той же площади PCB, что существенно экономит пространство на плате.
Улучшенные тепловые и электрические характеристики
Шарики пайки в BGA упаковке используются не только для электрических соединений, но и для теплопроводности, эффективно отводя тепло от микросхемы к PCB, что улучшает теплоотвод. Кроме того, благодаря коротким путям электрических соединений в BGA упаковке, потери при передаче сигналов минимальны, что способствует улучшению электрических характеристик.

Отличное теплоотведение
Шарики пайки в BGA упаковке эффективно проводят тепло, и вся нижняя поверхность микросхемы может использоваться для теплоотвода, что обеспечивает отличные тепловые характеристики. Это делает BGA упаковку особенно подходящей для электронных устройств с высокой плотностью мощности, таких как высокопроизводительные компьютеры и коммуникационное оборудование.
Минимальное повреждение выводов
В BGA упаковке шарики пайки не имеют длинных выводов, как в традиционной упаковке, поэтому они менее подвержены механическим напряжениям в процессе эксплуатации, что снижает риск повреждения выводов и повышает надежность упаковки.
Высокая механическая прочность
Благодаря способу соединения шариками пайки, BGA упаковка обладает высокой механической прочностью, способной эффективно противостоять внешним механическим ударам и вибрациям, что делает её особенно подходящей для применения в промышленности и военной технике, где требуется высокая надежность.
Недостатки
Сложность проверки и ремонта
Шарики пайки в BGA упаковке расположены на нижней стороне микросхемы, что затрудняет их прямую проверку и визуальный контроль. Традиционные методы визуального контроля не могут выявить дефекты шариков пайки, поэтому необходимо использовать передовые методы проверки, такие как рентгеновский контроль. Кроме того, при возникновении неисправности шариков пайки, ремонт также крайне сложен и часто требует замены всего устройства.

Чувствительность к влажности
Область соединения между шариками пайки и подложкой в BGA упаковке очень чувствительна к влажности, особенно в процессе пайки методом оплавления. Неконтролируемая влажность может привести к проблемам с качеством пайки. Поэтому в процессе производства и хранения BGA упаковки необходимо строго контролировать уровень влажности.
Высокие требования к технологии пайки
Технология пайки BGA упаковки предъявляет очень высокие требования, особенно в процессе пайки методом оплавления, где необходимо точно контролировать температурный профиль, чтобы обеспечить надежную пайку каждого шарика к PCB. Любые малейшие отклонения в технологии могут привести к плохому качеству пайки и негативно сказаться на надежности всей упаковки.
Контроль качества BGA
Оптическая микроскопия
Оптическая микроскопия является одним из основных методов контроля качества BGA упаковки. С помощью оптического микроскопа можно проводить визуальный осмотр BGA упаковки и выявлять явные дефекты, такие как отсутствие шариков пайки или их деформации.
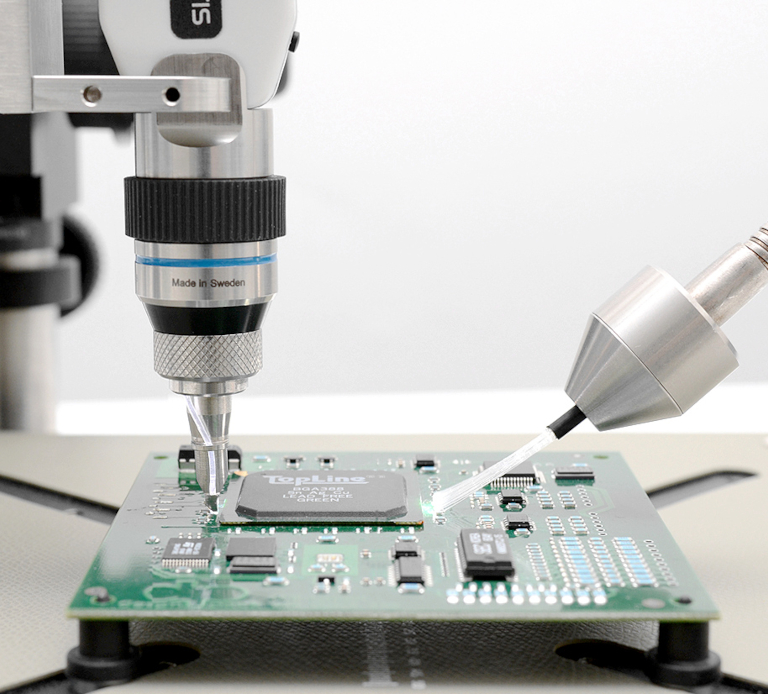
Электрический тест
Электрический тест измеряет электрические параметры в BGA упаковке, такие как сопротивление и емкость, для определения состояния соединений шариков пайки. Этот метод позволяет эффективно обнаруживать шарики с плохими электрическими характеристиками, повышая надежность упаковки.
Инфракрасная термография
Инфракрасная термография определяет состояние соединений шариков пайки путем анализа теплового распределения BGA упаковки во время работы. С помощью инфракрасной термографии можно визуально наблюдать тепловое распределение BGA упаковки и выявлять проблемы с соединениями шариков пайки.
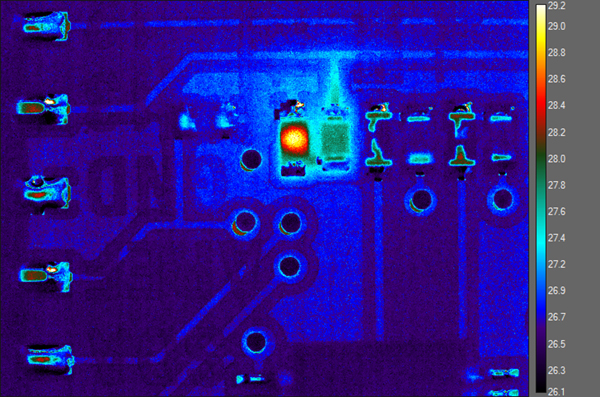
Рентгеновский контроль
Рентгеновский контроль – это метод неразрушающего контроля, который использует проникающую способность рентгеновских лучей для проверки состояния соединений шариков пайки внутри BGA упаковки. Рентгеновский контроль позволяет выявлять такие дефекты, как пустоты внутри шариков пайки и плохие соединения, которые трудно обнаружить традиционными методами, и является одним из важнейших методов контроля качества BGA упаковки.

Будущее BGA упаковки
С развитием электронных устройств требования к упаковочным технологиям постоянно повышаются. Благодаря высокой плотности, высокой производительности и надежности BGA упаковка будет играть все более важную роль в будущих электронных устройствах. С развитием полупроводниковых технологий размеры BGA упаковки будут уменьшаться, чтобы соответствовать требованиям миниатюризации. Шариковая решетка с малым шагом (Fine-pitch BGA, FBGA) станет основным направлением для удовлетворения потребностей в высокой плотности упаковки. Также BGA упаковка будет использовать более эффективные теплопроводящие материалы и оптимизированные конструкции для улучшения теплоотвода, повышения электрических характеристик, уменьшения потерь сигнала и повышения надежности электрических соединений. Увеличение экологической осведомленности приведет к развитию BGA упаковки в направлении большей экологичности и устойчивости, включая использование бессвинцовых припоев и экологически чистых материалов для уменьшения воздействия на окружающую среду.
Возможности JY Electronics в области BGA упаковки
Компания JY Electronics обладает богатым опытом и передовыми техническими возможностями в области BGA упаковки. Компания не только производит и собирает PCB с BGA упаковкой, но и предоставляет комплексную систему тестирования и проверки BGA-PCB продуктов, обеспечивая высочайшую точность и качество для удовлетворения разнообразных требований клиентов по интеграции BGA в их проекты PCB. Благодаря строгому контролю качества и передовым методам проверки, JY Electronics предлагает клиентам высококачественные решения по BGA упаковке, помогая им выделяться в условиях жесткой рыночной конкуренции. Конкретную производственную мощность BGA можно найти в таблице ниже:
|
Производственные возможности JY BGA |
|
| Проект | Возможности |
| Рентгеновский контроль | BGA пустоты (шаг между шарами 0.35 мм) |
| Поверхностный монтаж (SMT) | Минимальный BGA R-VTx: 0.35 мм |
| Перепайка BGA | Источник азота: не применяется |
| Максимальный размер печатной платы: 350 мм | |
| Точность температуры: ±1°C | |
| Совместимость с безсвинцовыми технологиями | |
Приглашаем вас связаться с нами для совместного сотрудничества.
- Phone: +86-411-66361648
- FAX: +86-576-88310656
- E-mail: jy@pcbchina.cn
- Web: https://www.pcbagoods.com

